คิวอาร์โค้ด

เกี่ยวกับเรา
สินค้า
ติดต่อเรา

โทรศัพท์

แฟกซ์
+86-579-87223657

อีเมล

ที่อยู่
ถนน Wangda, ถนน Ziyang, เขต Wuyi, เมือง Jinhua, จังหวัดเจ้อเจียง, จีน
การแกะสลักเทคโนโลยีเป็นหนึ่งในขั้นตอนสำคัญในกระบวนการผลิตเซมิคอนดักเตอร์ ซึ่งใช้ในการแยกวัสดุเฉพาะออกจากแผ่นเวเฟอร์เพื่อสร้างรูปแบบวงจร อย่างไรก็ตาม ในระหว่างกระบวนการกัดกรดแบบแห้ง วิศวกรมักจะประสบปัญหาต่างๆ เช่น ผลการโหลด ผลร่องไมโคร และผลการชาร์จ ซึ่งส่งผลโดยตรงต่อคุณภาพและประสิทธิภาพของผลิตภัณฑ์ขั้นสุดท้าย
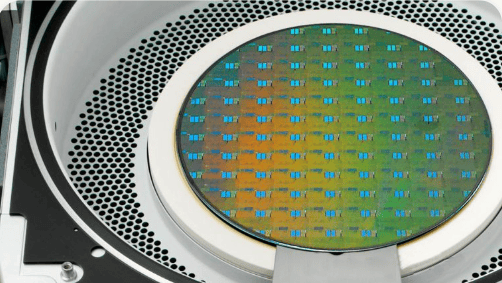
ผลการโหลดหมายถึงปรากฏการณ์ที่เมื่อพื้นที่การกัดเพิ่มขึ้นหรือความลึกของการกัดเพิ่มขึ้นในระหว่างการกัดแบบแห้ง อัตราการกัดจะลดลงหรือการกัดไม่สม่ำเสมอเนื่องจากการจ่ายพลาสมาที่ทำปฏิกิริยาไม่เพียงพอ ผลกระทบนี้มักจะเกี่ยวข้องกับคุณลักษณะของระบบการกัดกรด เช่น ความหนาแน่นและความสม่ำเสมอของพลาสมา ระดับสุญญากาศ ฯลฯ และปรากฏอย่างกว้างขวางในการกัดด้วยไอออนปฏิกิริยาต่างๆ
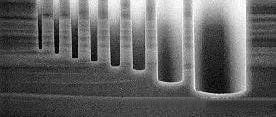
-ปรับปรุงความหนาแน่นของพลาสม่าและความสม่ำเสมอ: โดยการปรับการออกแบบแหล่งพลาสมาให้เหมาะสมเช่นการใช้พลังงาน RF ที่มีประสิทธิภาพมากขึ้นหรือเทคโนโลยีการสปัตเตอร์แมกนีตรอนความหนาแน่นที่สูงขึ้นและพลาสมากระจายอย่างสม่ำเสมอมากขึ้นสามารถสร้างขึ้นได้
-ปรับองค์ประกอบของก๊าซที่เกิดปฏิกิริยา: การเพิ่มปริมาณก๊าซเสริมที่เหมาะสมลงในก๊าซปฏิกิริยาสามารถปรับปรุงความสม่ำเสมอของพลาสมาและส่งเสริมการปลดปล่อยผลพลอยได้จากการแกะสลักอย่างมีประสิทธิภาพ
-เพิ่มประสิทธิภาพระบบสูญญากาศ: การเพิ่มความเร็วและประสิทธิภาพของปั๊มสุญญากาศสามารถช่วยลดระยะเวลาการกัดกรดที่เป็นผลพลอยได้ในห้องเพาะเลี้ยง ซึ่งจะช่วยลดผลกระทบของโหลด
-ออกแบบเลย์เอาท์การพิมพ์หินด้วยภาพถ่ายที่เหมาะสม: เมื่อออกแบบเค้าโครงการพิมพ์หินด้วยแสง ควรคำนึงถึงความหนาแน่นของรูปแบบเพื่อหลีกเลี่ยงการจัดเรียงที่มีความหนาแน่นมากเกินไปในพื้นที่ท้องถิ่น เพื่อลดผลกระทบของเอฟเฟกต์โหลด
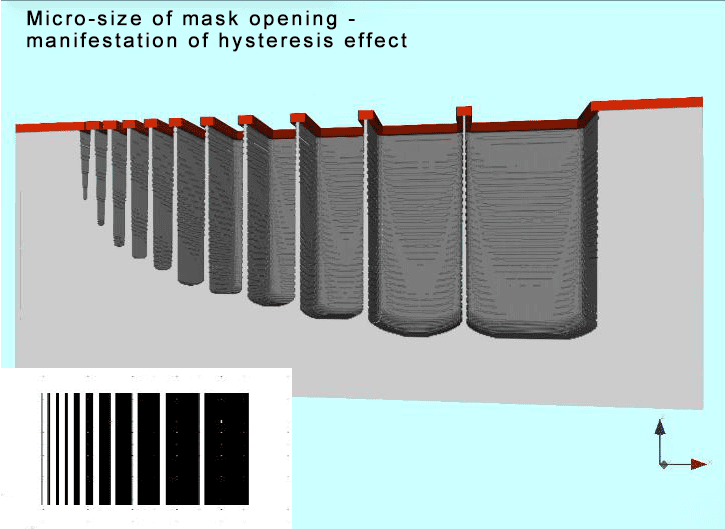
เอฟเฟกต์การวิ่งข้ามขนาดเล็กหมายถึงปรากฏการณ์ที่ว่าในระหว่างกระบวนการแกะสลักเนื่องจากอนุภาคพลังงานสูงที่กระทบกับพื้นผิวการแกะสลักที่มุมเอียงอัตราการแกะสลักที่อยู่ใกล้ผนังด้านข้างสูงกว่าในพื้นที่ส่วนกลาง -ห้องเก็บของบนผนังด้านข้าง ปรากฏการณ์นี้เกี่ยวข้องอย่างใกล้ชิดกับมุมของอนุภาคเหตุการณ์และความลาดชันของผนังด้านข้าง
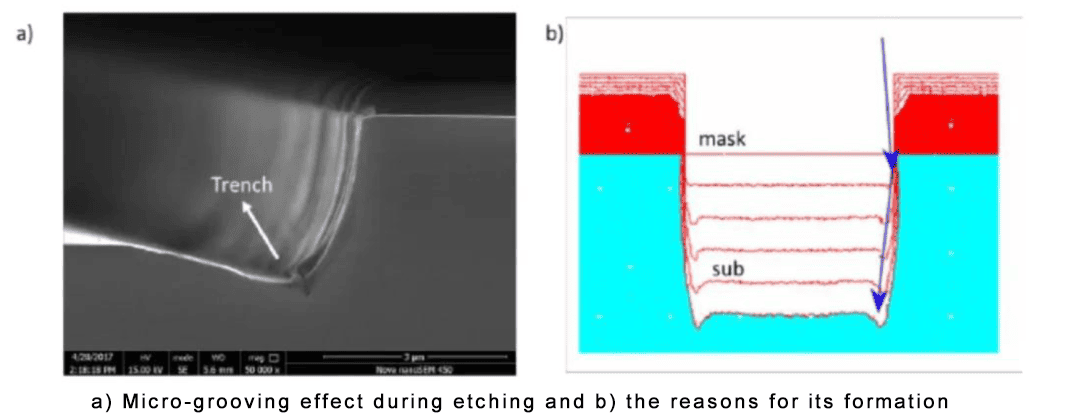
-เพิ่มพลังงาน RF: การเพิ่มกำลัง RF อย่างเหมาะสมจะช่วยเพิ่มพลังงานของอนุภาคที่ตกกระทบได้ ทำให้สามารถโจมตีพื้นผิวเป้าหมายในแนวตั้งได้มากขึ้น ซึ่งช่วยลดอัตราการแกะสลัก ความแตกต่างของผนังด้านข้าง
-เลือกวัสดุหน้ากากแกะสลักที่เหมาะสม: วัสดุบางชนิดสามารถต้านทานเอฟเฟกต์การชาร์จได้ดีกว่า และลดเอฟเฟกต์ร่องลึกขนาดเล็กที่กำเริบจากการสะสมประจุลบบนหน้ากาก
-ปรับสภาวะการแกะสลักให้เหมาะสม: โดยการปรับพารามิเตอร์อย่างประณีตเช่นอุณหภูมิและความดันในระหว่างกระบวนการแกะสลักการเลือกและความสม่ำเสมอของการแกะสลักสามารถควบคุมได้อย่างมีประสิทธิภาพ
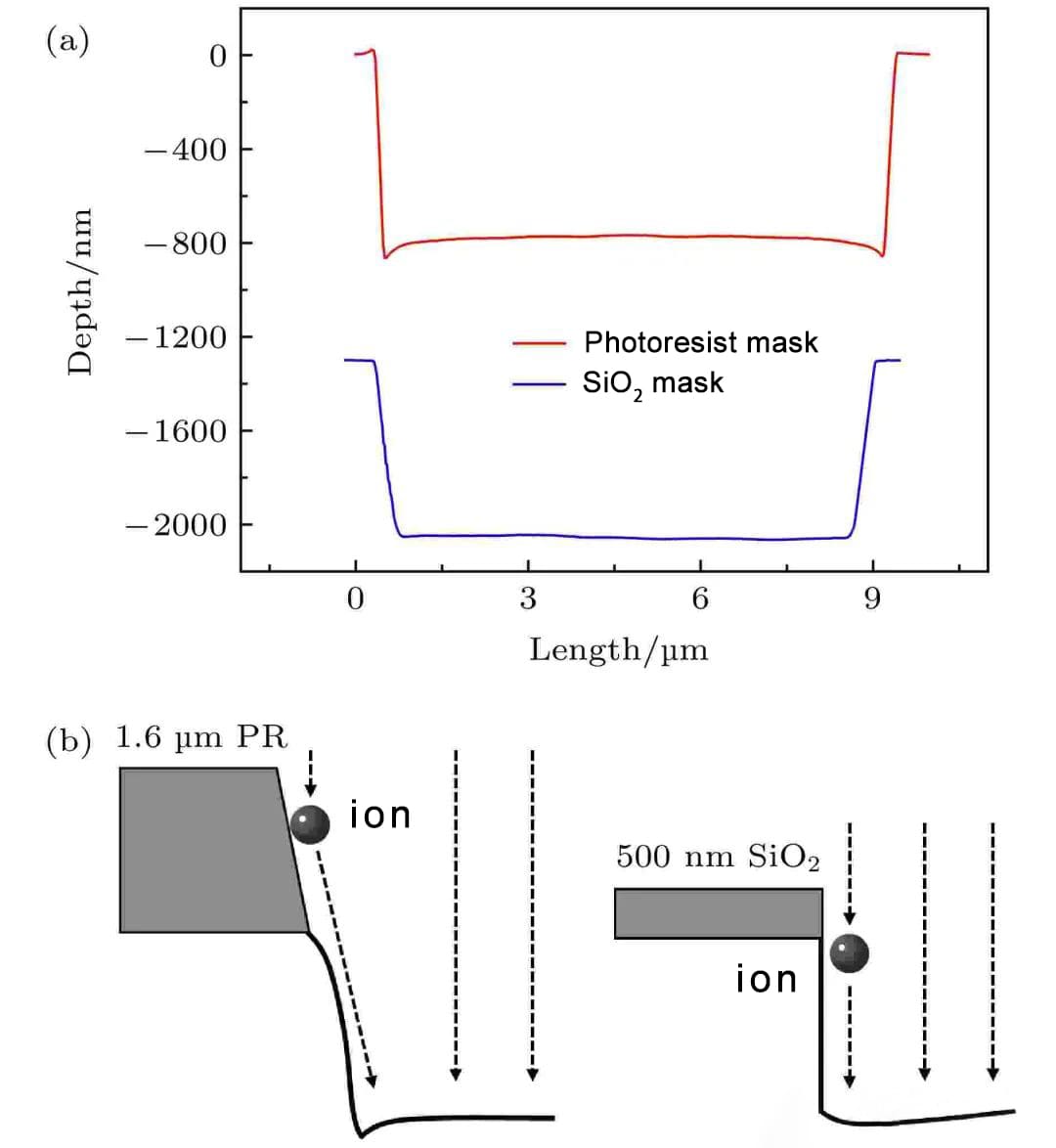
เอฟเฟกต์การชาร์จเกิดจากคุณสมบัติฉนวนของหน้ากากแกะสลัก เมื่ออิเล็กตรอนในพลาสมาไม่สามารถหลบหนีได้อย่างรวดเร็วพวกมันจะรวมตัวกันบนพื้นผิวหน้ากากเพื่อสร้างสนามไฟฟ้าในท้องถิ่นรบกวนเส้นทางของอนุภาคเหตุการณ์และส่งผลกระทบต่อการกัดกร่อนของการแกะสลักโดยเฉพาะอย่างยิ่งเมื่อแกะสลักโครงสร้างที่ละเอียด
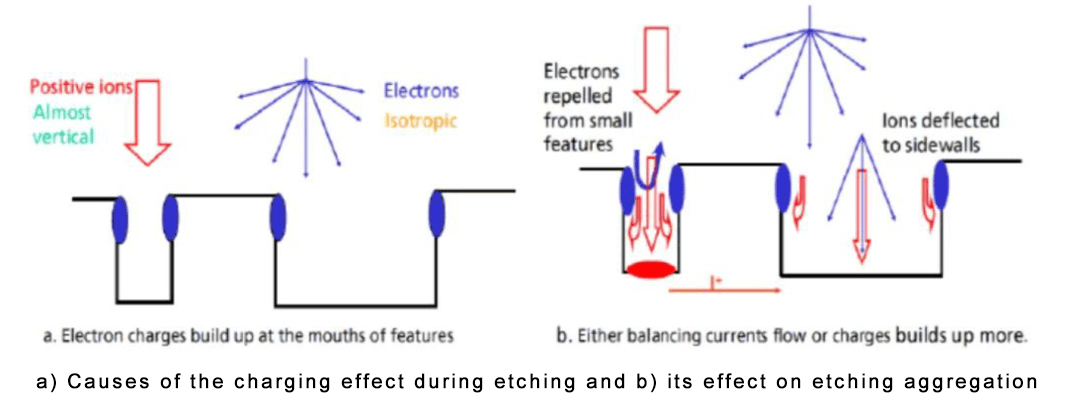
- เลือกวัสดุหน้ากากแกะสลักที่เหมาะสม: วัสดุที่ได้รับการรักษาเป็นพิเศษหรือชั้นหน้ากากนำไฟฟ้าสามารถลดการรวมตัวของอิเล็กตรอนได้อย่างมีประสิทธิภาพ
-ดำเนินการแกะสลักเป็นระยะ: โดยการขัดจังหวะกระบวนการแกะสลักเป็นระยะและให้อิเล็กตรอนมีเวลาเพียงพอที่จะหลบหนีผลการชาร์จสามารถลดลงได้อย่างมีนัยสำคัญ
-ปรับสภาพแวดล้อมการแกะสลัก: การเปลี่ยนองค์ประกอบของก๊าซความดันและเงื่อนไขอื่น ๆ ในสภาพแวดล้อมการแกะสลักสามารถช่วยปรับปรุงความเสถียรของพลาสมาและลดผลกระทบของการชาร์จที่เกิดขึ้น
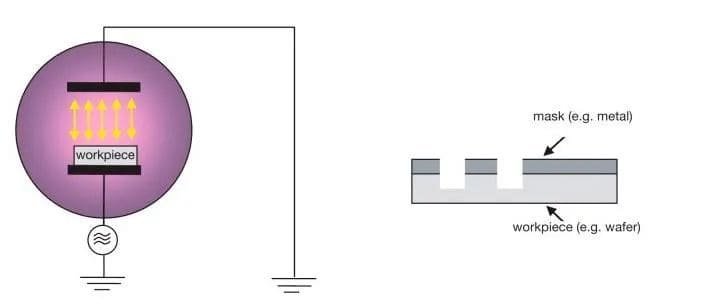



+86-579-87223657


ถนน Wangda, ถนน Ziyang, เขต Wuyi, เมือง Jinhua, จังหวัดเจ้อเจียง, จีน
ลิขสิทธิ์© 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. สงวนลิขสิทธิ์.
Links | Sitemap | RSS | XML | นโยบายความเป็นส่วนตัว |
